Удаление обоих нарушенных слоев и снижение неровностей поверхности до уровня, свойственного оптическим системам и составляющего сотни, а иногда десятки ангстрем осуществляется обезжириванием и полировкой.
3.2 Обезжиривание поверхности
Как уже было сказано, поверхность отшлифованной пластины не удовлетворяет качеством. Для ее доводки необходимо удалить молекулярные органические и химически связанные с поверхностью загрязнения, а затем – остаточные ионные и атомарные. Для этого применяют обезжиривание поверхности.
Обезжиривание (отмывка) в органических растворителях (толуоле, дихлорэтане, спиртах: этиловом, метиловом и др) применяется для удаления с поверхности пластин жиров животного и растительного происхождения, минеральных масел, смазок, воска, парафина и других органических и механических загрязнений и наиболее часто выполняется погружением, в парах, с помощью ультразвука, струйной обработкой.
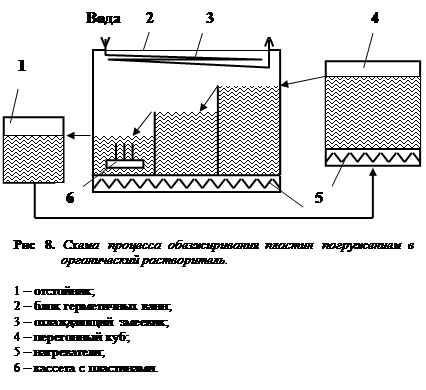 Обезжиривание погружением (рис 8) выполняют в специальных герметичных установках с двумя-четырьмя сваренными в единый блок ваннами с повышающимся уровнем жидкости. Полупроводниковые пластины в химически инертных кассетах, например из фторопласта, погружают в ванну с
Обезжиривание погружением (рис 8) выполняют в специальных герметичных установках с двумя-четырьмя сваренными в единый блок ваннами с повышающимся уровнем жидкости. Полупроводниковые пластины в химически инертных кассетах, например из фторопласта, погружают в ванну с
|
Ультразвуковое обезжиривание выполняют в специальных ваннах, дно и стенки которых совершают механические колебания с УЗ-частотой (рис 9).
В жидкости возникают вихревые акустические потоки с высокими скоростями, которые интенсивно перемешивают жидкость, а также упругие волны (сгустки и разрежения за счет смещения частиц жидкости). В местах разрежения жидкости появляются кавитационные пузырьки. Под действием сил, которые стремятся вернуть смещенные частицы в исходное положение, эти пузырьки после кратковременного существования захлопываются. При интенсивных колебаниях и захлопывании кавитационных пузырьков возникают ударные волны, сообщающие большие ускорения молекулам жидкости, которые с силой ударяются о поверхность обрабатываемых пластин и сбивают с них частицы загрязнений. Благодаря кавитации жидкость способна проникать в глубокие поры, каналы, углубления, которые при обычных методах остаются неочищенными.
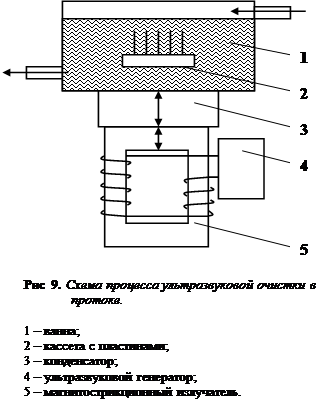
3.3 Полировка
 Обезжиренные пластины подвергаются окончательной обработке – полировке. Чаще всего используется химическая полировка (травление), т.е. по существу растворение поверхностного слоя полупроводника в тех или иных реактивах. Обязательными компонентами таких реактивов являются окислитель (обычно азотная кислота) и растворитель образующегося окисла (обычно плавиковая кислота. Кроме этих компонентов в состав травителей входят ускорители и замедлители реакции. Выступы и трещины на поверхности стравливаются быстрее, чем основной материал, и в целом поверхность выравнивается. Чтобы раствор не застаивался у поверхности травления, применяется динамическое травление, т.е. вращение ванны во время процесса (рис 10)
Обезжиренные пластины подвергаются окончательной обработке – полировке. Чаще всего используется химическая полировка (травление), т.е. по существу растворение поверхностного слоя полупроводника в тех или иных реактивах. Обязательными компонентами таких реактивов являются окислитель (обычно азотная кислота) и растворитель образующегося окисла (обычно плавиковая кислота. Кроме этих компонентов в состав травителей входят ускорители и замедлители реакции. Выступы и трещины на поверхности стравливаются быстрее, чем основной материал, и в целом поверхность выравнивается. Чтобы раствор не застаивался у поверхности травления, применяется динамическое травление, т.е. вращение ванны во время процесса (рис 10)
Иногда химическую полировку сочетают с предварительной механической. Для этого тканые или нетканые материалы (сатин, батист, сукно, замшу и др) натягивают на обычный шлифовальный круг и закрепляют хомутиком. Полирование выполняют в несколько этапов, постепенно уменьшая размер зерна и твердость абразива, а на последнем этапе полностью исключают абразивное воздействие на обрабатываемый материал (рис 7).
4 Фотолитография
Именно внедрение литографии в полупроводниковое производство в 1957 г. определило дальнейшее развитие элементной базы электроники и позволило перейти от дискретных элементов к интегральным.
В производстве современных микросхем литография – самый универсальный технологический процесс. Она позволяет воспроизводимо и с большой точностью выполнять сложные рисунки с размерами элементов до одного и менее микрометра в разнообразных материалах. Литография применяется при изготовлении полупроводниковых и пленочных структур, для получения всевозможных канавок и углублений в полупроводниковых и иных материалах. С ее помощью изготавливают шаблоны – инструменты для проведения самого процесса литографии, получают сквозные отверстия в фольге при изготовлении прецезионных свободных масок, выводных рамок или лент, применяемых для автоматизированной сборки и герметизации интегральных микросхем.
Основное назначение литографии при изготовлении структур микросхем – получение на поверхности пластин контактных масок с окнами, соответствующими топологии формируемых технологических слоев, и дальнейшая передача топологии (рисунка) с маски на материал данного слоя.
Сущность процесса литографии заключается в следующем. Литография представляет собой сложный технологический процесс, основанный на использовании явлений, происходящих в актинорезистах при актиничном облучении.
Актинорезисты, на практике называемые просто резистами, представляют собой материалы, чувствительные к излучению определенной длины волны (к актиничному излучению), и стойкие (резист – сопротивляться) к технологическим воздействиям, применяемым в процессе литографии. Под действием излучения происходящие в резистах процессы необратимо меняют их стойкость к специальным составам – проявителям.
Резисты, растворимость которых в проявителе увеличивается после облучения, называются позитивными. Негативные резисты после облучения становятся практически нерастворимыми в проявителе.
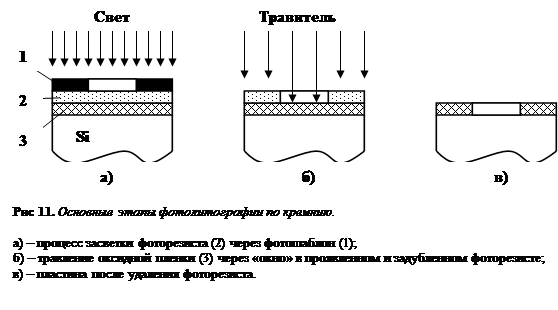 |
В зависимости от типа применяемого излучения различают оптическую, рентгеновскую, электронную и ионную литографии. Более подробно мы рассмотрим оптическую литографию или фотолитографию.
Фоторезисты представляют собой сложные полимерные композиции, в составе которых имеются фоточувствительные и пленкообразующие компоненты, растворители и специальные добавки.
Фотошаблоны являются основными инструментами фотолитографии, с их помощью производится локальное облучение фотослоя в соответствии с топологией микросхемы. Фотошаблон для изготовления структур микросхем – плоскопараллельная пластина (или гибкая пленка) из прозрачного для УФ-излучения материала с нанесенным на ее рабочую поверхность непрозрачным пленочным рисунком, соответствующим топологии одного из слоев структуры микросхемы и многократно повторенным со строго определенным шагом в пределах рабочей области пластины (пленки).
Для основы фотошаблонов применяют оптическое боросиликатное стекло или полимерные пленки, которые хорошо обрабатываются и не изменяют свойств под действием излучения. Для выполнения рисунка применяют галоидно-серебряную фотографическую эмульсию (эмульсионные фотошаблоны), металлы (металлизированные фотошаблоны) и полупрозрачные для видимого света оксиды или другие материалы (транспарентные, цветные фотошаблоны).
Рис 11 наглядно демонстрирует процесс фотолитографии. На поверхность двуокиси кремния наносится равномерный слой фоторезиста. Сверху на него накладывается фотошаблон. Сквозь него фоторезист засвечивается ультрафиолетовым светом. После этого пластину с фоторезистом проявляют; в процессе проявления засвеченные участки фоторезиста стравливаются и в этих местах обнажается поверхность двуокиси кремния. Оставшийся (незасвеченный) слой фоторезиста подвергают термическому дублению – полимеризации, в результате чего этот слой становится нечувствительным к химическим травителям. Поэтому, когда на следующем этапе пластину подвергают травлению, растворяются лишь обнаженные участки двуокиси кремния, вплоть до поверхности самой пластины, вследствие чего в оксидной маске получается необходимая совокупность «окон», через которые в дальнейшем проводят локальную диффузию или напыление контактов. Далее удаляется задубленный слой фоторезиста и пластина с оксидной маской готова к дальнейшей обработке.
5 Методы получения полупроводниковых слоев и переходов
Все рассмотренные ранее этапы технологии производства ИС можно охарактеризовать как предварительные. Действительно, проделав эти действия мы получим лишь заготовку интегральной схемы. Теперь же надо монтировать на ней элементы, которые и будут определять работу готового изделия. Для этого на пластине необходимо создать полупроводниковые слои и переходы. Данные этапы являются предварительными и основными этапами сборки микросхемы.
Полупроводниковые структуры интегральных микросхем нельзя изготовить, не применив хотя бы один из трех процессов: эпитаксиальное наращивание полупроводниковых слоев, диффузионное и ионное легирование. Рассмотрим каждый из них.
5.1 Эпитаксия
Эпитаксия – процесс наращивания монокристаллических слоев на монокристаллических подложках. Монокристаллические подложки в процессе роста эпитаксиального слоя выполняют ориентирующую роль затравки, на которой происходит кристаллизация.
Эпитаксиальные слои можно наращивать в вакууме, из парогазовои и жидкой фазы.
 В зависимости от состава материалов слоя и подложки различают процессы автоэпитаксии и гетероэпитаксии. Если составы материалов практически одинаковы, например слой кремния на кремниевой пластине, процесс называют автоэпитаксией. Гетероэпитаксия – процесс ориентированного нарастания вещества, отличающегося по химическому составу от вещества подложки.
В зависимости от состава материалов слоя и подложки различают процессы автоэпитаксии и гетероэпитаксии. Если составы материалов практически одинаковы, например слой кремния на кремниевой пластине, процесс называют автоэпитаксией. Гетероэпитаксия – процесс ориентированного нарастания вещества, отличающегося по химическому составу от вещества подложки.
Для осаждения слоев кремния из парогазовой фазы в промышленном производстве используют кремнийсодержащие соединения: тетрахлорид кремния, силан. В соответствии с применяемыми исходными продуктами называют и методы: хлоридный и силановый.
Хлоридный метод основан на использовании химического взаимодействия паров тетрахлорида кремния с чистым водородом.
![]()
 В результате реакции на подложке осаждается чистый кремний, а пары HCl уносятся потоком водорода. Эпитаксиальный слой осажденного кремния монокристалличен и имеет ту же структуру и ориентацию, что и подложка.
В результате реакции на подложке осаждается чистый кремний, а пары HCl уносятся потоком водорода. Эпитаксиальный слой осажденного кремния монокристалличен и имеет ту же структуру и ориентацию, что и подложка.
Если к парам тетрахлорида кремния добавить пары галоидных соединений бора (BBr3 ) или фосфора (PCl3 ), то эпитаксиальный слой будет иметь уже не собственную, а примесную проводимость, поскольку в ходе химической реакции в кремний будут внедряться акцепторные атомы бора или донорные атомы фосфора.
5.2 Диффузионное легирование
Внедрение примесей в исходную пластину (в эпитаксиальный слой) путем диффузии при высокой температуре является одним из основных способов создания диодных и транзисторных структур в интегральной технологии.
Диффузия может быть локальной и общей. В первом случае она осуществляется на определенных участках пластины через специальные маски (рис 12 а, б), во втором – по всей поверхности (рис 10 в).
Диффузию можно проводить и однократно и многократно (двойная, тройная диффузия). Например, в исходную пластину n-типа можно во время первой диффузии внедрить акцепторную примесь и получить р-слой, а затем во время второй диффузии внедрить в полученный слой (на меньшую глубину) донорную примесь и тем самым обеспечить трехслойную структуру (рис 10 г).
5.3 Ионное легирование
Основной особенностью ионного легирования является возможность воспроизводимого получения заданной концентрации примеси на данной глубине практически на любой площади пластины. Это обусловлено тем, что можно с большой точностью задавать ток ионного луча. Возможно получение неглубоких однородно легированных слоев, а также резких р-n переходов. Распределениями примесей можно легко управлять в широких пределах, изменяя дозу облучения, энергию и угол падения ионов.
 Ионное легирование осуществляется путем бомбардировки пластины ионами примеси, ускоренными в специальных установках (ускорителях частиц) до значительной энергии. На схеме установки ионного легирования (рис 13) ионы примеси из источника ионов входят в анализатор по массе. Необходимость разделения ионов по массе вызвана тем, что вытягиваемый из источника поток ионов неоднороден по составу; в нем присутствуют ионы различных элементов и соединений и многозарядные ионы. Для разделения ионов по отношению массы к заряду применяют различные сепараторы, которые основаны на взаимодействии движущегося иона с магнитными и электрическими полями или с комбинацией этих полей. В большинстве установок сепараторами являются секторные магнитные системы, в которых происходит Поворот пучка ионов на угол менее 180° (например, 45°, 6О0
или 90°).
Ионное легирование осуществляется путем бомбардировки пластины ионами примеси, ускоренными в специальных установках (ускорителях частиц) до значительной энергии. На схеме установки ионного легирования (рис 13) ионы примеси из источника ионов входят в анализатор по массе. Необходимость разделения ионов по массе вызвана тем, что вытягиваемый из источника поток ионов неоднороден по составу; в нем присутствуют ионы различных элементов и соединений и многозарядные ионы. Для разделения ионов по отношению массы к заряду применяют различные сепараторы, которые основаны на взаимодействии движущегося иона с магнитными и электрическими полями или с комбинацией этих полей. В большинстве установок сепараторами являются секторные магнитные системы, в которых происходит Поворот пучка ионов на угол менее 180° (например, 45°, 6О0
или 90°).
Ионы с определенным отношением массы к заряду входят в электростатический ускоритель ионов, к электродам которого от отдельного высоковольтного источника подводится напряжение, в отдельных установках до 200 кВ и выше. Ускоренные ионы через щель поступают в фокусирующую систему, а затем в сканирующую систему, которая обеспечивает перемещение сфокусированного пучка ионов по полупроводниковой пластине, расположенной в приемной камере. В установке обеспечивается необходимый высокий вакуум. Получаемый ток пучка ионов в различных установках составляет от десятков микроампер до нескольких миллиампер. Сканирование пучка в одном поперечном направлении механическое, а в другом электростатическое, площадь сечения пучка 1 ¸ 2 мм2 . Число одновременно закладываемых в камеру пластин с диаметром 75 ¸ 150 мм в разных установках составляет 96 ¸ 24. Следует заметить, что глубина проникновения ионов, зависящая от их энергии, составляет 0,1 ¸ 0,5 мкм, т.е. очень мала и недостижима при диффузионном легировании. Это позволяет получать резкие профили (большие градиенты) распределения примеси.
Ионное легирование характеризуется универсальностью и гибкостью, позволяет с высокой точностью управлять количеством легирующей примеси (путем регулировки тока пучка ионов) и глубиной внедрения – изменением энергии (напряжения источника). Процесс ионного легирования может осуществляться при низких температурах, вплоть до комнатных, благодаря чему сохраняются исходные электростатические свойства кристаллов. Это большое преимущество метода перед диффузионным легированием. Низкая температура позволяет проводить ионное легирование на любом этапе технологического цикла. Однако недостатком метода (кроме необходимости сканирования пучка) является возникновение обилия радиационных дефектов в облученном полупроводнике, вплоть до образования аморфного слоя. Такие дефекты полностью удается устранить путем кратковременного отжига (в кремнии при 900 ¸ 1100°С).
6 Технология полупроводниковых биполярных и МДП ИМС
Итак, теперь мы подошли вплотную к основным технологическим операциям изготовления интегральных микросхем.
Современные интегральный микросхемы (в дальнейшем – ИМС) можно разделить на два класса: полупроводниковые и гибридные. К гибридным относятся ИМС, в которых содержатся отдельные навесные элементы. К полупроводниковым относятся ИМС, все элементы которой выполняются в объеме или на поверхности единой полупроводниковой подложки. В процессе изготовления такой схемы необходимо избирательно формировать транзисторы, диоды, резисторы, конденсаторы и их соединения на одной полупроводниковой пластине – подложке и обеспечивать достаточно хорошую изоляцию, исключающую паразитное взаимодействие между ними.
6.1 Элементы ИМС
Технология ИМС предполагает значительное отличие элементной базы от обыкновенной электротехники. На рис 13 представлены основные элементы ИМС.
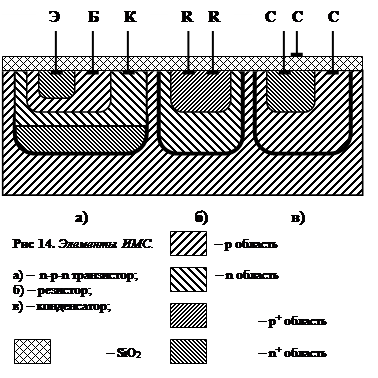 Полупроводниковая ИМС имеет общую подложку из кремния р-типа. На ней выполняются транзисторы (рис 14 а), резисторы (рис 14 б), конденсаторы (рис 14 в) и диоды.
Полупроводниковая ИМС имеет общую подложку из кремния р-типа. На ней выполняются транзисторы (рис 14 а), резисторы (рис 14 б), конденсаторы (рис 14 в) и диоды.
Диоды образуют из транзисторных структур, используя различные способы соединений их электродов.
Имеется пять способов включения транзистора как диода, отличающихся различной крутизной прямой ветви ВАХ и временем восстановления обратного сопротивления. Наименьшее время переключения имеет диод, одним электродом которого служит эмиттер, а другим – соединенные вместе коллектор и база.
Полупроводниковые резисторы изготовляют одновременно с активными элементами. Они обычно выполняются в виде прямоугольного слоя полупроводника при базовой диффузии и называются диффузионными. В таких резисторах используется объемное сопротивление материала, имеющего определенную степень легирования. Диффузионные резисторы могут иметь номинальные значения сопротивлений от нескольких ом до двух десятков килоом.
Конденсаторы полупроводниковых ИМС выполняются двух видов. Часто в качестве конденсаторов используют смещенный в обратном направлении р-n переход. Емкость такого конденсатора зависит от величины обратного напряжения, а последовательно с ней всегда оказывается включенным большое объемное сопротивление полупроводникового материала. Таким образом можно изготовить конденсаторы емкостью до сотни пикофарад. Другой разновидностью являются металл-окисел-полупроводниковые конденсаторы, которые образуются областью n+ -типа (от эмиттерной диффузии) и металлической пленкой алюминия, разделенными слоем двуокиси кремния. Эти конденсаторы могут иметь емкость до нескольких сотен пикофарад.
Рассмотренные элементы полупроводниковых ИМС обладают паразитными компонентами, ограниченным диапазоном номинальных значений и весьма малыми рассеиваемыми мощностями. При разработке топологии ИМС необходимо стремиться к исключению паразитных связей между ее элементами и к обеспечению требуемого теплоотвода.
6.2 Изготовление биполярных ИМС с изоляцией p - n переходами
 На рис 15 показана структура интегрального n-р-n-транзистора изолированного p-n переходом. В этом транзисторе подложкой является кремний р-типа; на ней созданы эпитаксиальный n-слой и так называемый скрытый n+
-cлoй. Изолирующий р-n-переход создается путем диффузии акцепторной примеси на глубину, обеспечивающую соединение образующихся при этой диффузии р-областей с р-подложкой. В этом случае эпитаксиальный n-слой разделяется на отдельные n-области (изолирующие «карманы»), в которых и создаются потом транзисторы. Эти области будут электрически изолированы только в том случае, если образовавшиеся р-n переходы имеют обратное включение. Это достигается, если потенциал подложки n-р-n транзистора будет наименьшим из потенциалов точек структуры. В этом случае обратный ток через р-n переход незначителен и практически исключается связь между n-областями (карманами) соседних транзисторов.
На рис 15 показана структура интегрального n-р-n-транзистора изолированного p-n переходом. В этом транзисторе подложкой является кремний р-типа; на ней созданы эпитаксиальный n-слой и так называемый скрытый n+
-cлoй. Изолирующий р-n-переход создается путем диффузии акцепторной примеси на глубину, обеспечивающую соединение образующихся при этой диффузии р-областей с р-подложкой. В этом случае эпитаксиальный n-слой разделяется на отдельные n-области (изолирующие «карманы»), в которых и создаются потом транзисторы. Эти области будут электрически изолированы только в том случае, если образовавшиеся р-n переходы имеют обратное включение. Это достигается, если потенциал подложки n-р-n транзистора будет наименьшим из потенциалов точек структуры. В этом случае обратный ток через р-n переход незначителен и практически исключается связь между n-областями (карманами) соседних транзисторов.
Теперь, зная принцип изоляции p-n переходом, и воспользовавшись материалом предыдущих пунктов, можно дать развернутое описание технологии.
а) Изготовление биполярных ИМС методом разделительной диффузии насквозь эпитаксиального слоя (рис 16) состоит из двух этапов: изготовления эпитаксиальной структуры со скрытыми n+ -областями (а-в) и изготовления биполярной ИМС на этой структуре (г-з).
|
Эпитаксиальный n-слой выращивают обычно хлоридным методом. Толщина слоя 3 ¸ 25 мкм в зависимости от назначения ИМС.
По рассмотренной технологии изготавливают ИМС первой и второй степени интеграции. Возможности процесса для получения более высоких степеней интеграции ограничены из-за ряда недостатков ИМС: наличия
29-04-2015, 04:08
